C-V测量技术、技巧与陷阱—— C-V测量参数提取的局限性
·电容:从<10fF到1微法
·电阻:从<0.1欧姆到100M欧姆
·小电感:从<1nH到10mH
·栅介质:可以提取的等价栅氧厚度范围从不到10纳米到几百纳米。可以检测出的电介质玷污浓度从每平方厘米5e9个离子到约1e13个离子,界面阱范围从约1e10/cm2/ev到1e13/cm2电荷左右(取决于器件结构)。现代仪器和探针台的超低电容测量功能能够测量更厚的叠层电介质。
·MOS掺杂:可以提取MOSFET的掺杂分布情况,灵敏度范围从约1e14/cm3到1e18/cm3,掺杂深度从0.01µm到10µm。少数载流子寿命从1µs到10ms。可从C-V测量中测得10µs的寿命时间。
·PN和肖特基结掺杂:可在0.1µm到100µm的深度范围内测出约1e 13/cm3t到1e18/cm3的二极管载流子浓度。
·FET和BJT建模参数:除了测量器件和材料特性之外,C-V测试还可进行直接测量用于构建FET和BJT晶体管[2]中的参数。
重要的是要注意很多因素都会影响这些参数提取范围,例如最大电压值、器件尺寸和栅氧厚度。幸运的是,已有很多文献能够帮助广大研究人员和工程师判断所需的测量范围是否与现在的C-V测量技术所具有的功能很好的匹配。







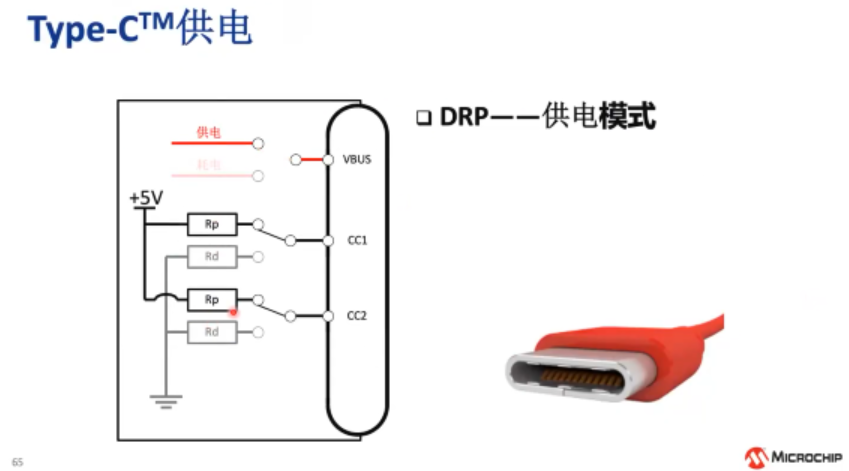




评论