三星全面发力先进封装,今年相关营收将挑战1亿美元

3月21日消息,在AI芯片热潮的带动下,先进封装需求大爆发,而目前在先进封装领域,台积电可谓是一家独大,拿下了大部分的AI芯片的先进封装订单。不过,韩国芯片巨头三星电子也在积极切入先进封装领域,近日还喊出了今年先进封装营收将挑战突破1亿美元新高的口号。
据路透社、韩联社等外媒报导,在3月20日召开的三星年度股东大会上,三星高管表示,尽管今年经济情势不确定性仍高,不过随着AI大时代来临,科技创新也带来了更多新机遇,将积极拓展相关业务,包括AI內存、先进封装、智慧终端(On-device AI)、机器人和数字医疗等新兴领域,激发新的成长动能。
三星于2023年12月成立了先进封装业务团队(AdVanced Package Business Team),为装置解决方案(Device Solutions)事业群辖下的部门。
根据此前据韩国媒体The Elec的报道显示,为增强先进封装代工能力,三星开始导入混合键合(hybrid bonding)技术,预计用于下一代X-Cube、SAINT等先进封装。
据了解,混合键合与现有键合方法相比,可提高I/O和布线长度。三星最新投资是为了加强先进封装能力,推出采用混合键合的X-Cube。业界猜测,混合键合也可应用于三星今年开始推出的SAINT(三星先进互连技术)平台,包括三种3D堆叠技术,即SAINT S、SAINT L和SAINT D。
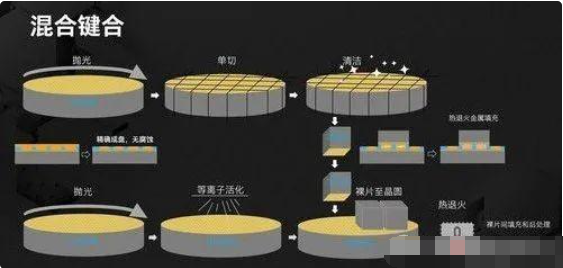
其中,SAINT S是将SRAM垂直堆叠在CPU等逻辑芯片上;SAINT L是将逻辑芯片堆叠在逻辑芯片,或应用处理器(AP)堆叠;SAINT D则是DRAM和CPU、GPU等逻辑芯片垂直堆叠。
据了解,晶圆代工龙头台积电的SoIC(系统整合芯片)也是提供混合键合的3D封装服务,设备同样也是由应用材料和贝思半导体共同提供。英特尔也将混合键结技术应用在其3D封装技术Foveros Direct,并于去年商业化。
业界预期,三星对混合键结设施的投资有望赢得NVIDIA和AMD等大客户青睐,因为无晶圆厂客户对混合键结需求正不断增加。
另外,目前大热的HBM(高带宽内存)的生产也依赖于先进封装技术。作为目前仅有的三大HBM供应商之一,三星也将为英伟达的AI芯片供应HBM,不过目前三星的HBM仍未通过英伟达的认证。数名分析人士指出,三星HBM3的良率目前只有10~20%,SK海力士的HBM3良率却已达到了60~70%。
在此次的三星年度股东大会上,三星共同执行长庆桂显(Kye-Hyun Kyung)表示,投资先进封装效果将在下半年全面显现,并利用IC设计、制造、封测的一条龙服务优势,全力抢攻高频宽內存(HBM)市场。
编辑:芯智讯-浪客剑
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。











