3D IC助攻移动处理器效能再上层楼
晶圆代工厂技术掌握度高
本文引用地址://m.amcfsurvey.com/article/126362.htm看准未来3DIC将是半导体产业势在必行的发展趋势,台湾创意电子正积极透过SiP技术的基础,进一步跨进3DIC技术的研发。由于3DIC发展过程中遇到的挑战与SiP大致类似,因此创意电子在SoC与SiP所累积的丰富经验,无疑成为其挺进3D IC市场最佳的技术后盾。
台湾创意电子营运处SiP/ 3D IC项目处长林崇铭表示,未来印刷电路板面积将持续缩减,芯片设计势必走向更高整合度,所以半导体业者必须藉由3D IC堆栈芯片技术来减少采用的芯片数量;而发展3D IC所面临的问题,如半导体设计自动化(EDA)工具不完备,以及如何确保已知良裸晶(Known Good Die)来源等,其实与SiP极为相似,且更加复杂,因此,若无扎实的SiP技术发展基石,则遑论3D IC的研发。
林崇铭进一步指出,虽然3D IC的问题较SiP复杂许多,但是凭借创意电子在SiP设计领域打下的深厚基础,将可顺利解决3D IC技术面所遭遇的挑战,这也是创意电子毅然决定跨入3D IC的重要因素。
目前创意电子在3D IC的发展尚在起步阶段,林崇铭表示,现阶段创意电子业务来源仍以SoC与SiP为主,3D IC技术仍未有客户,预期2013年,3D IC整体生态链的建构更完备、市场更成熟之后,创意电子3D IC的业务才会开始起飞,届时将锁定移动装置与高效能组件市场,初步将先整合逻辑与内存,或逻辑与模拟组件,抑或逻辑组件堆栈。在此之前,创意电子也将先建立2.5D芯片堆栈技术,以顺利升级至3D IC。
事实上,目前阻碍业者导入3D IC的一大因素,在于成本过高。林崇铭认为,现阶段,3D IC整体供应链尚未建置完全是不争的事实,导致3D IC成本过高,不过,此一鸡生蛋、蛋生鸡的问题,预计短时间内将可顺利解决,原因在于半导体业者对于3D堆栈技术需求已逐渐涌现,不论是采用硅穿孔(TSV)技术实现的3D IC,或英特尔提出的三闸极(Tri-gate)3D晶体管结构,皆已渐成气候,意味相关供应链亦已有初步的准备,因此未来3D IC的发展与生态系统将可望更趋完备。
3D IC俨然已成为未来超越摩尔定律的重要技术,因而吸引包括晶圆代工厂及封装厂纷纷抢进。然而,由于硅穿孔技术在晶圆制造前段即须进行,因此晶圆代工厂掌握的技术层级较封装厂高,在3D IC的技术与市场发展较具优势。
台湾南台科技大学电子系教授唐经洲表示,硅穿孔为3D IC最重要的技术,采用硅穿孔技术的芯片产品才能称为3D IC,而要进行硅穿孔,较佳的方式是在硅晶圆制造过程中即先行钻孔,如此一来,遭遇的问题将较少,而晶圆前段制程各项技术属晶圆厂最为熟知,自然晶圆厂商在3D IC的制造可掌握较多关键技术。
不过,对封装业者而言,3D IC自然也是不可忽略的商机。唐经洲指出,3D IC属于SiP技术的一环,擅于将各式晶圆进行封装工作的封装厂,亦跃跃欲试。然而,碍于封装厂的技术多属于晶圆后段制程,若要取得已经过硅穿孔的晶圆半成品,依旧须从晶圆厂购得,抑或者再投入庞大的资金建置前段制程,惟目前3D IC发展尚未相当明朗,封装业者对于庞大的投资能否达到平衡或进一步回收,仍抱持观望态度,以致于封装业者在3D IC市场的主导性不若晶圆厂。
虽然目前封装厂在3D IC市场优势较为薄弱,但并不代表封装厂在芯片立体堆栈的市场将完全没有机会。唐经洲认为,3D IC硅穿孔技术毕竟技术门坎仍相当高,成本依然高昂,因此许多对3D IC有兴趣的业者,如应用处理器大厂,即先选择采用2.5D架构,作为进入3D IC的基础。唐经洲强调,2.5D架构仅纯粹的芯片堆栈,毋须硅穿孔,因此技术难度相对较低,封装厂可掌握2.5D封装的关键技术,因此现阶段封装厂包括日月光、硅品皆已投入2.5D封装技术的发展。
专门提供IC制造设备的住程(SPTS)营销副总裁David Butler亦表示,就该公司客户的发展情形来看,2.5D将是半导体产业前进3D IC架构的第一步,包括封测业者与晶圆代工业者目前研发重点皆以2.5D为主,并计划以此为基础发展3D IC。
陈瑞铭:3D IC市场尚未全面启动
观察整体半导体产业的发展,2011年第三季旺季不旺已成必然,但第四季与2012年,随着微软(Microsoft)Windows 7移动装置产品的问世与超微(AMD)试图将x86技术进行新的应用,如透过40或28纳米实现更低功耗芯片,以及Windows 8将可支持安谋国际、英特尔与超微架构,这些非苹果(Apple)阵营移动装置新一波的市场高潮,将更带动整体半导体产业的发展,除了促进SoC加速朝先进制程发展外,3D IC将是另一个受惠的技术。
惠瑞捷(Verigy)台湾分公司总经理陈瑞铭表示,3D IC受到瞩目的原因,除了可提高整合度与处理器效能外,更重要的是,毋须透过最先进的制程即可完成,因此主要的晶圆厂与行动处理器厂商势必进入3D IC的研发。
不过,3D IC硅穿孔技术却也带来许多挑战,陈瑞铭指出,硅穿孔技术仍在初步发展阶段,技术质量仍不稳定,且磨薄晶圆的技术门坎也很大,加上产业生态链未建立完全,也没有统一的标准可供业者遵循。此外,如何测试3D IC质量亦为一大学问,因此3D IC的市场尚未全面启动,反而是利用在基板上长晶、毋须钻孔的2.5D技术将成为SiP进展到3D IC的过渡技术。此外,2.5D亦已标准化,以此标准为基础也将加速3D IC标准的问世。
除了技术的挑战外,成本亦为3D IC发展不顺遂的原因。蒯定明指出,由于目前3D IC产业链并未建置完全,因此3D IC的成本仍然相当高昂,导致3D IC将不会成为普遍使用的芯片技术,且应用产品也将锁定于对高成本组件接受度较大的高阶产品。
综上所述,移动装置无疑是助长3D IC发展的主要推手,即便仍有诸多挑战待解,3D IC市场起飞已指日可待。日前刚结束的SEMICON Taiwan中,日月光集团总经理暨研发长唐和明即表示,3D IC将是后PC时代,亦即移动运算时代的主流,即使全球经济发展速度减缓,各厂推动研发脚步并不停歇。今年以来从上游IC设计、整合组件制造商(IDM)、晶圆代工厂,到后段封测厂及系统整合厂商,都朝制定逻辑IC和内存连结的共同标准迈进,2011年底即可看到成果,并做为业者开发的依据,预计2013年将为3D IC起飞元年。







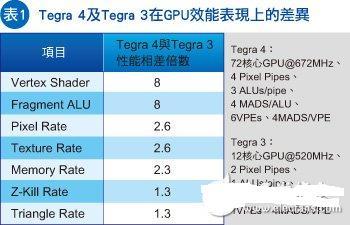



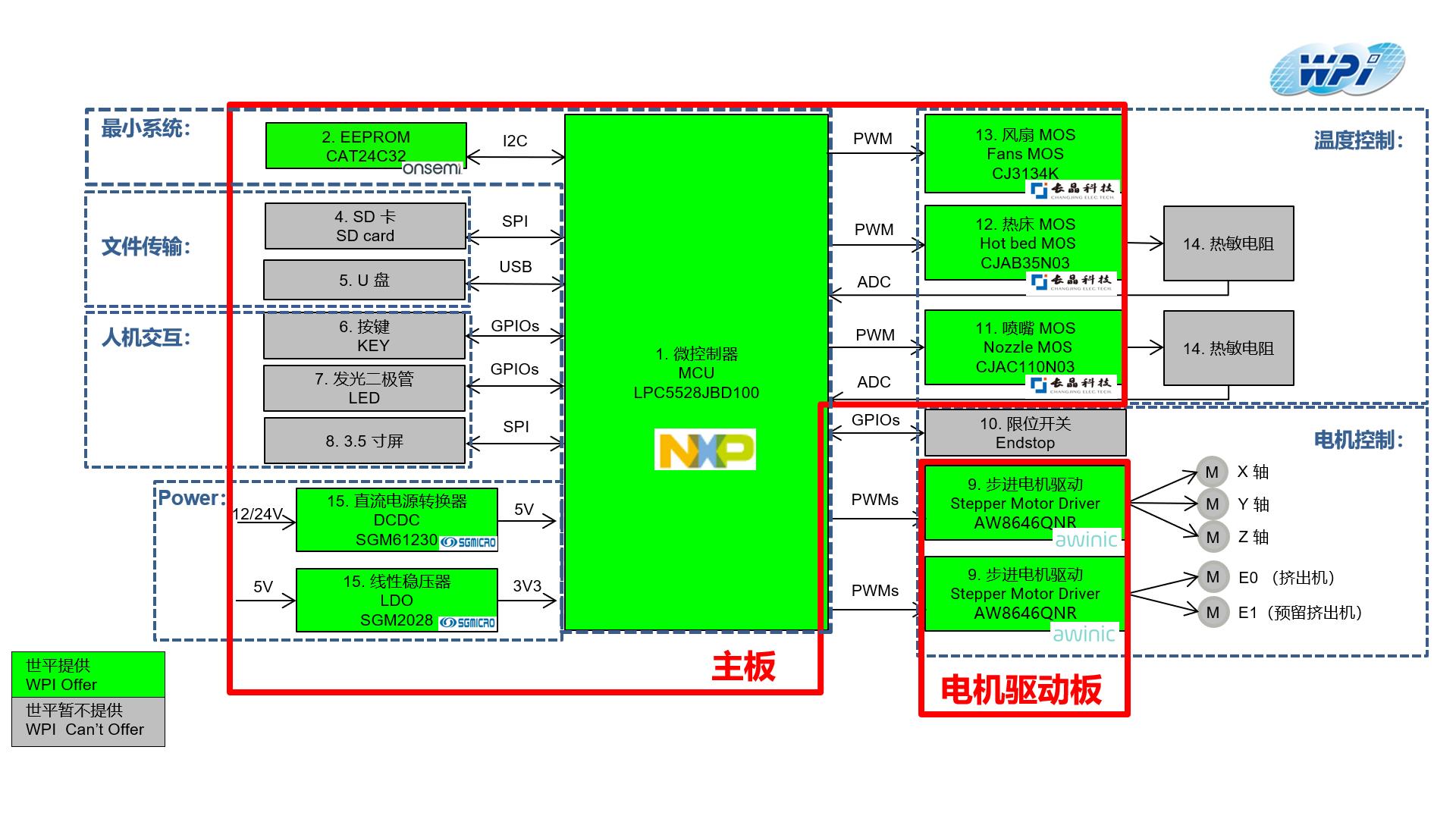


评论