基于电力网通信芯片的量产测试研究
摘要:讨论了数模混合芯片的典型测试方法,并按测试方法进行了测试开发;讨论了测试调试中的问题以及降低测试成本的方法。该设计可满足芯片大规模量产的测试需求,并能够达到预期设计目标。
关键词:电力网;通信芯片;量产测试;数模混合
0 引言
集成电路测试是对集成电路或模块进行检测,通过测量对于集成电路的输出响应和预期输出进行比较,以确定或评估集成电路元器件功能和性能的过程。它是验证设计、监控生产、保证质量、分析失效以及指导应用的重要手段。按测试的目的不同,可将测试分为三类:验证测试、生产测试和使用测试。本文主要讨论的内容是生产测试。生产测试的基本目的是识别有缺陷的芯片,并防止它们流出制造片进入下一级生产过程,以节约整体成本。
由于集成电路的集成度不断提高,测试的难度和复杂度也越来越高,当前大规模集成电路生产测试已经完全依赖于自动测试设备(Auto matic Test Equipment,ATE)。测试工程师的任务就是根据被测器件(Device Under Test,DUT)的产品规范(Specification)要求制定测试方案(Test Plan),并利用ATE的软、硬件资源对DUT施加激励信号、收集响应,最后将输出响应与预期要得到的信号进行对比或计算得出测试结果,最终判断芯片能否符合最初设计要求以决定出厂或丢弃。测试失效的芯片可收集返回给生产厂家,分析失效原因以提高良率。按照测试方案,将芯片测试分为晶圆测试(中测,也叫CP测试)和封装测试(成测,也叫FT测试)。其中FT测试也是就芯片成品的最后一次测试,用来保证芯片的出厂品质;而CP测试主要是在芯片量产初期,晶圆良率不高时,为了减少对失效芯片进行封装的费用而进行的测试,同时CP测试的结果还可以反馈给晶圆厂家进行工艺调整,以提高良率。其ATE的测试程序流程图如图1所示。
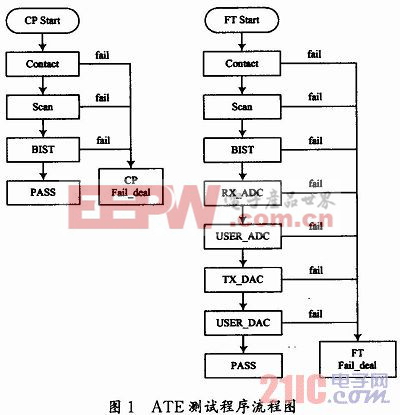
图中CP测试程序的三部分Contact、Sean、BIST都与FT测试程序中此三部分一致,不同的是错误处理(Fail deal)部分的处理不同。CP测试中DUT是整个晶圆,未通过测试的芯片可以通过打墨点或是机器记录位置的方式标记出,待晶圆划片时,把错误芯片分类挑出,称为分BIN。在FT测试中,因为是已经封装完成的芯片,所以当芯片未通过测试时,直接通过机械手(Handler)将错误芯片丢弃或分类。FT测试为了充分利用ATE测试资源,采用了四同测的方式;而CP测试是量产初期过渡项目,为了节约探针卡制作成本,采用单测方式。
1 项目测试描述
1.1 Contact测试
利用被测管脚与地之间的二极管进行连接性测试。施加电流使二极管导通,正常连接时管脚上的电压值应为二极管管压降。如图2所示。其管脚与电源之间的连接性测试原理与此相同。
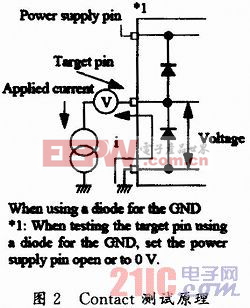
为了防止二极管电压偏差和电压测量时的误差等影响引入不必要的量产损失,在实际测试中的判决电压值为:对地连接性-1~0.1 V,对电源连接性0.1~1V。
1.2 BIST,Scan测试
BIST与Scan的测试方式基本相同,都是对芯片输入一测试向量然后比对输出向量的检测。测试向量(pattern)由后端仿真得出的波形产生(WGL,Wave Generation Language)文件转换而来。BIST作为普通功能测试,施加激励,对输出进行判断。虽然Sean测试是结构性测试,但对于ATE而言,其测试方法与功能测试并无区别,只是Scan测试可以较少的测试向量达到较高的测试覆盖率。ATE功能测试原理如图3所示。
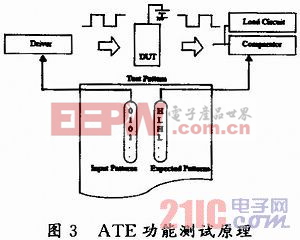




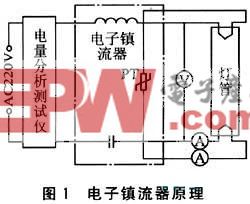









评论