华为、英伟达突破芯片大战界限
据报道,华为和中国 EDA 公司开发了一种集成电路(IC)设计自动化平台,用于生产制程节点小至 14nm 的半导体芯片。
本文引用地址://m.amcfsurvey.com/article/202304/445237.htm据媒体报道,该技术的评估和测试应于今年完成。
如果测试和评估成功完成,中国可能会朝着克服美国政府对其半导体产业的制裁迈出一大步。
14nm 是中芯国际使用的最先进的工艺节点,中芯国际运营着中国最大的半导体代工厂。新的 EDA 工具应涵盖中国工业、汽车和消费应用所需的大部分芯片。
新的 EDA 工具,如果像报道的那样可行,也可能给 EDA 行业领导者 Synopsys,Cadence Design Systems 和 Siemens EDA(前身为 Mentor Graphics)带来麻烦,所有这些都位于美国,并受到美国政府对中国出口限制的约束。
这些限制目前只影响他们最先进的技术,即用于设计从 3nm 开始的全环栅晶体管的软件。
Cadence 和 Synopsis 最近在中国的销售额约占 15%,两家公司的总销售额都以两位数的速度增长。然而,Synopsys 本财年对投资者的指导假设美国政府的出口管制不会进一步变化,而 Cadence 指出其地理收益组合可能会发生重大变化。
Mentor Graphics 在被西门子收购后于 2017 年退市,现在是该公司数字工业部门的一部分,西门子 EDA 似乎正在与其两个主要竞争对手保持一致,这三家公司合计占全球 EDA 行业收入的 75% 左右。
除华为外,从事 EDA 开发的中国公司还包括 Empyrean Technology,X-Epic,Cellixsoft,Xpedic 等。Empyrean 提供模拟和混合信号 IC,SoC 和平板显示器(FPD)设计解决方案,是最先进的。
根据 Digitimes 的一份报告,与三星代工合作的 23 家 EDA 公司中有 8 家是中国的,他们通过技术和有竞争力的价格实现了这一地位。美国人对中国压低价格以抢占市场份额的担忧开始成为现实。
中国 EDA 产业的下一个目标节点将是 7nm,这是目前该国光刻能力的极限。由于禁止向中国出口 EUV 光刻设备,因此较小节点的进入壁垒急剧上升。
与此同时,半导体设计和相关的光刻技术也在前沿迅速发展。2022 年 10 月,研究机构 TrendForce 写道,如果目前的趋势继续下去,
「... 中国在 10nm 以上的工艺中实现半导体自主化并不困难"
「致力于 SoC、云计算芯片、GPU 发展的中国本土 IC 设计人员,为了满足产品升级的迭代需求,注定要转向更先进的制造工艺,并有望在未来 2-4 年内走向 4nm 制造工艺」
但美国对 EDA 软件的限制影响「预计将在 2025 年逐步显现,不仅推迟了一些中国国内 IC 设计人员的开发进度,甚至造成发展停滞。
随着华为 14nm EDA 工具的公布,这一预测直接指向下一个战场。
3 月 21 月,全球领先的 GPU 设计商 Nvidia 宣布推出一个名为 cuLitho 的新软件库,为计算半导体光刻技术带来加速计算。
CuLitho 使用当前解决方案所需功率的一小部分将光掩模的生产速度提高三到五倍。随着芯片制造商转向 2nm 及以下制程,它应该会带来更好的设计规则,更高的密度和更高的良率。
该技术是与 Synopsys(全球最大的 EDA 公司)、ASML(EUV 光刻设备的垄断生产商)和台积电(世界领先的 IC 代工厂)合作开发的,历时 4 年。台积电计划从 6 月开始生产。
根据 Techopedia 的定义,软件库是一套用于开发软件程序和应用程序的数据和编程代码。光刻是在硅晶圆上创建 IC 设计的过程。光掩模是设计模板。
ASML 对计算光刻的解释如下:
「在平版印刷过程中,光的衍射以及 [晶圆上] 感光层中的物理和化学效应会使机器试图打印的图像变形(可以想象这是试图用宽水彩画笔画一条细线)。
「计算光刻使用制造过程的算法模型,使用来自我们机器和测试晶圆的关键数据进行校准...... 为了优化扫描仪(光刻机)、掩模和工艺,以提高设备的可制造性和产量...
「如果没有计算光刻技术,芯片制造商就不可能制造出最新的技术节点。
参与 cuLitho 开发和应用的高层管理人员对这项技术有这样的看法:
英伟达首席执行官黄仁勋(Jensen Huang)表示:「随着光刻技术达到物理极限,英伟达引入 cuLitho 以及与我们的合作伙伴台积电、ASML 和 Synopsys 的合作,使晶圆厂能够提高产量,减少碳足迹,并为 2nm 及更高层奠定基础。」
台积电首席执行官 CC Wei 博士表示:「cuLitho 团队通过将昂贵的操作转移到 GPU 上,在加速计算光刻方面取得了令人钦佩的进展,这一发展为台积电在芯片制造中更广泛地部署逆光刻技术和深度学习等光刻解决方案开辟了新的可能性,为半导体规模的持续发展做出了重要贡献。」
ASML 首席执行官 Peter Wennink 表示:「我们计划将对 GPU 的支持集成到我们所有的计算光刻软件产品中,我们与 NVIDIA 在 GPU 和 cuLitho 上的合作应该会为计算光刻带来巨大的好处,从而为半导体微缩技术带来巨大的好处,在高数值孔径极紫外光刻时代尤其如此。」
Synopsys 首席执行官 Aart de Geus 表示,计算光刻,特别是光学接近校正(OPC),正在推动最先进芯片的计算工作负载的界限,通过与我们的合作伙伴 NVIDIA 合作,在 cuLitho 平台上运行 Synopsys OPC 软件,我们将时间从几周缩短到几天。
光学接近校正可补偿由光衍射或过程效应引起的误差,以提高光刻的精度。ASML 的高数值孔径 EUV 光刻系统计划于 2025 年进行大批量生产。









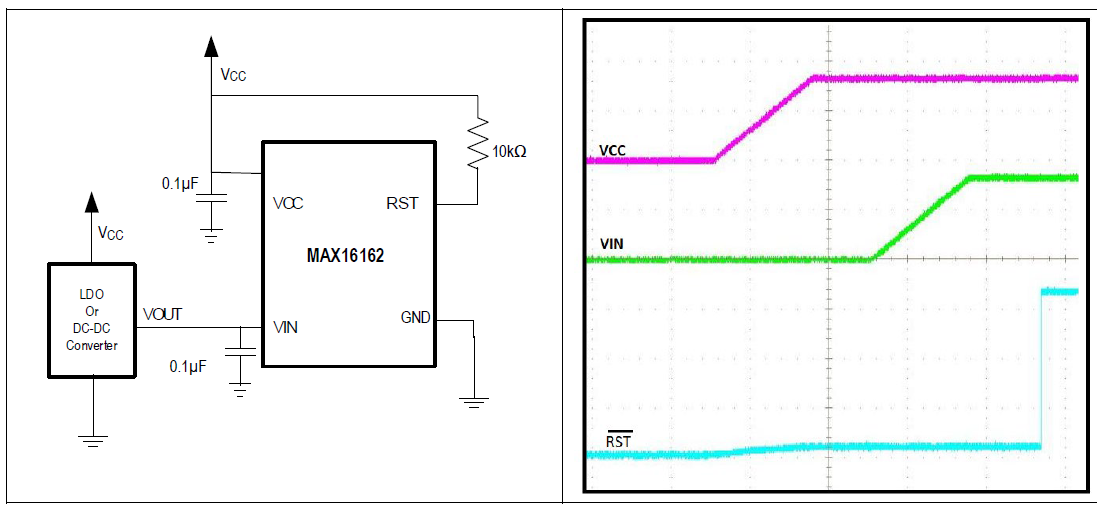


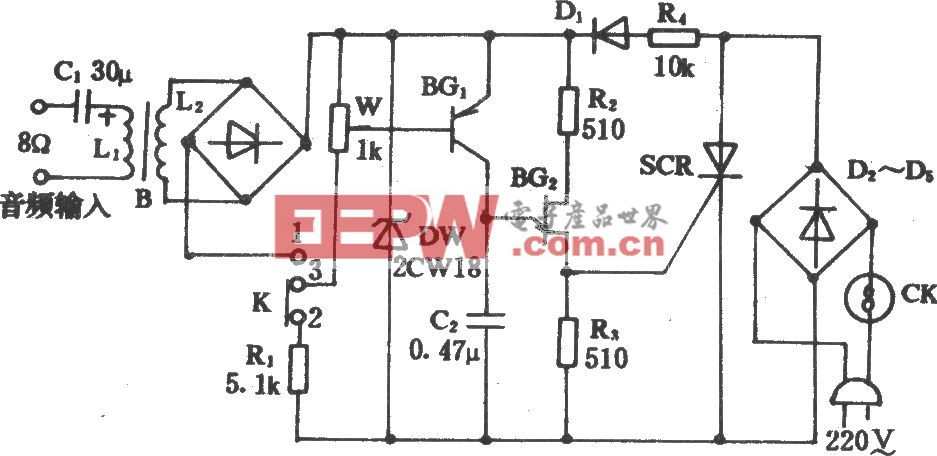









评论