激光微细加工中微小曝光区温度测量系统的改进
在激光微细加工技术中,人们需要了解曝光区温度分布的细节,尤其是焦斑中心温度、热斑边界等重要信息。针对半导体基片温度的测量方法已有很多报道,但大多是测量基片的平均温度,不能满足上述要求。本课题组曾经报道的微小高温区温度不接触实时测量系统,测量区域直径最小可以达到18μm,温度分辨能力可以达到1℃,基本满足激光微细加工的要求。但系统在实际应用时遇到几个问题。首先是要进一步提高温度分辨率时,测温范围达不到要求。其次是测量曝光区温度分布时,需手动调节测温套筒的位置,系统的调整和读数不方便,只能测较少的点,不能很好的反映曝光区的温度分布,同时难以寻找到曝光区的最高温度点,使得测温带来误差。本文首先简单介绍现有系统的结构和工作原理,然后详细分析了产生这些问题的原因,以及对温度测量的影响。在此基础上,提出一种计算机温度测量系统,较好的解决了这些问题。该系统采用高精度、低漂移电流放大器对光电探测器产生的光电流进行放大,并将放大后的电压信号转换为数字信号输入计算机进行记录、处理,在温度为600℃附近,将温度分辨率提高到0.2℃,并且扩大了测温范围。通过计算机软件对最高光电流值进行判断,可精确调整测温套筒,使半导体基片表面位置位于探测器光敏面的共轭面位置。同时,计算机通过对曝光区进行快速扫描,获得温度场的分布,以及对最高温度点进行准确定位。
1.系统实验装置和工作原理
系统实验装置如图1所示,CO2激光器输出的10.6μm激光束经反射镜M、锗透镜L2聚焦后照射在表面已制备好含Zn的SiO2乳胶膜的半导体基片S上,完成扩散结的写入等。曝光区近似为圆。基片上曝光区受激光照射升温而发出较强的热辐射,由透镜L1将曝光区中被测面元的热辐射能会聚在探测器D的光敏面上,并通过光电探测器把被测面元的热辐射转换为光电流,实际上也就是把被测面元的温度信号变为电流信号,最后通过检流计显示出光电流值,据此可得出相应的温度值。

图1 温度测量系统的实验装置
R=KσT4(1)
式中,K是被测基片在Σ区的平均发射本领,σ为Stefan常数,T为曝光区中测量点的温度。进一步假设透镜接受到的被测面元(探测器光敏面的共轭面元)的辐射全部会聚到探测器光敏面,则探测器D输出的光电流为
IP=RI(T)KσT4S1S′/(πd21)(2)
式中,RI(T)为探测器的电流响应率,S1为透镜L1的通光孔面积,S′为测量区域面积,即Σ中与探测器D的光敏面共轭面元的面积,d1为L1到基片表面的距离。
(2)式表明,探测器D输出的光电流对温度的变化非常敏感,只要对光电流有一定的分辨率,就可达到较高的温度分辨率。显然,这种辐射测温法具有不接触测量的功能。
由于探测器光敏面的共轭面元(被测面元)面积S′、发射本领K难以准确测定,电流响应率RI(T)是温度函数,所以依据式(2)用理论计算的方法由光电流IP求出温度T比较困难。实验中,需进行温度定标,即确定检流计的电流示值同被测面元温度之间的关系。温度定标的实验方法见文献[6],通过温度定标后,就可以根据检流计的电流示值读出温度值。
2.系统在实际使用时遇到的问题
2.1温度分辨率和测量范围不能同时满足要求
图2 是系统对GaAs基片进行定标实验的结果。从图中可以看出,当温度从400℃变到700℃时,光电流将从几个纳安变到一百多个纳安,变化范围很大。系统中采用检流计来测量探测器产生的光电流。当采用检流计的高灵敏度档时,量程不能满足这样宽的测量范围。因此只能使用检流计的次灵敏档,但这样测量得出的精度又不能令人满意。由于光电流与温度的非线性关系,特别是在低温时,光电流分辨率的降低使得温度分辨率很低。这一点从图2中可以看出。在温度为600℃时,光电流分辨率为InA对应的温度分辨率约为1℃,而在温度为450℃时,对应的温度分辨率降为约10℃。因此,需要采用新方法在不减小测量范围的条件下提高对温度的分辨率。

图2 定标实验结果

图3 温度的径向分布曲线




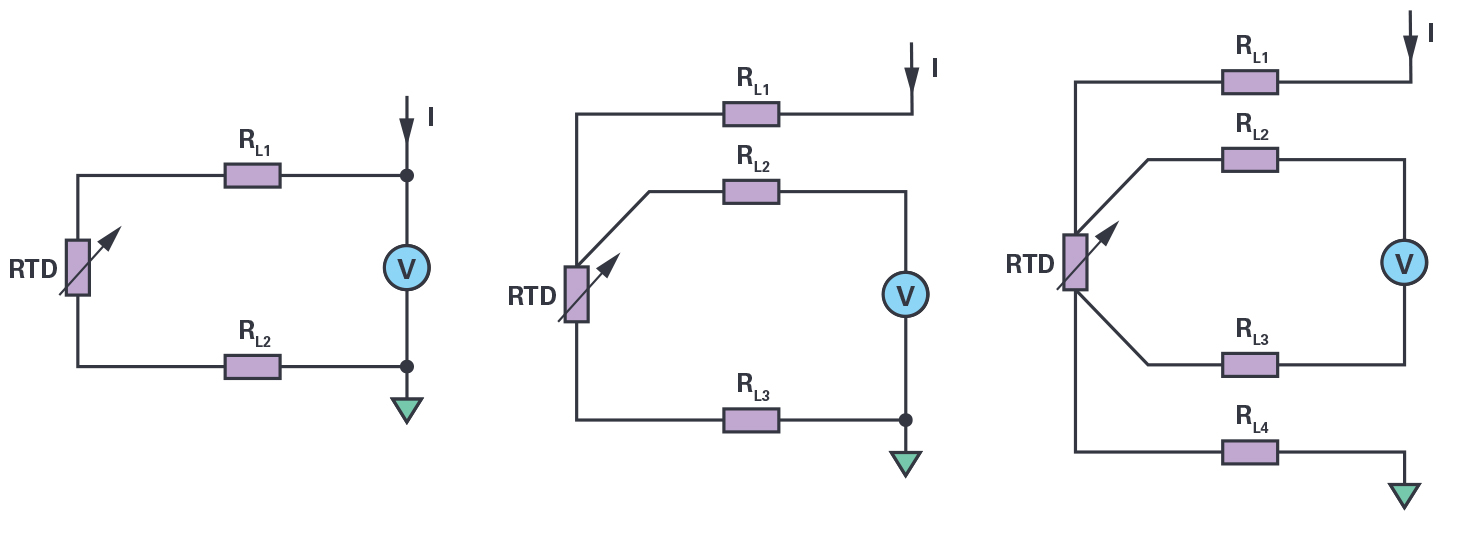
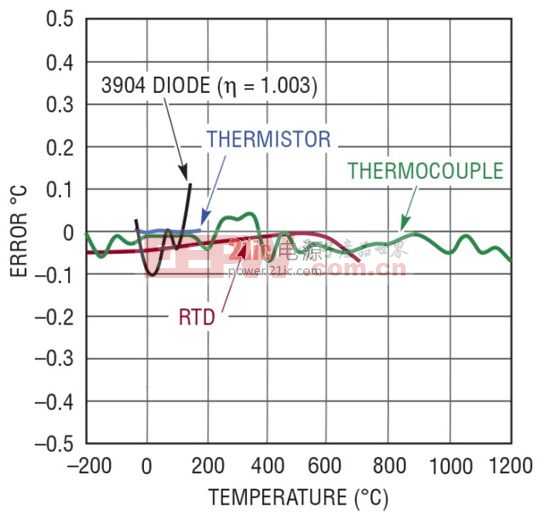

评论