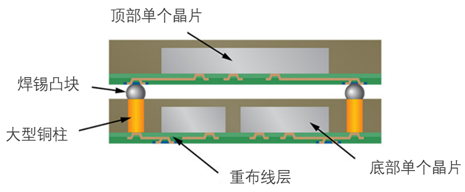
- 随着集成电路设计师将更复杂的功能嵌入更狭小的空间,异构集成包括器件的3D堆叠已成为混合与连接各种功能技术的一种更为实用且经济的方式。作为异构集成平台之一,高密度扇出型晶圆级封装技术正获得越来越多的认可。此种封装解决方案的主要优势在于其封装的基片更少,热阻更低,电气性能也更优秀。这是一个体现“超越摩尔定律”的例子,即使用 “摩尔定律”以外的技术也能实现更高的集成度和经济效益。图1. 2.5D封装中的中介层结构异构集成技术高密度扇出型封装技术满足了移动手机封装的外形尺寸与性能要求,因此获得了技术界的广泛关注。
- 关键字:RDLCMP
rdl介绍
您好,目前还没有人创建词条rdl!
欢迎您创建该词条,阐述对rdl的理解,并与今后在此搜索rdl的朋友们分享。
创建词条
关于我们-
广告服务-
企业会员服务-
网站地图-
联系我们-
征稿-
友情链接-
手机EEPW
Copyright ©2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《电子产品世界》杂志社 版权所有 北京东晓国际技术信息咨询有限公司

京ICP备12027778号-2 北京市公安局备案:1101082052 京公网安备11010802012473