- 目前台积电先进封装CoWoS的制程瓶颈在于硅穿孔(TSV)技术,TSV硅穿孔芯片堆栈并非打线接合,而是在各逻辑芯片钻出小洞,从底部填充入金属,使其能通过每一层芯片。再以导电材料如铜、多晶硅、钨等物质填满,形成连接的功能,最后将晶圆或晶粒薄化加以堆栈、结合(Bonding),作为芯片间传输电讯号用之立体堆栈技术。随着IC设计业者继续将更多的逻辑、内存和特殊功能芯片整合到先进的2.5D和3D封装中,每个封装中的TSV互连导线数量扩展到数千个。为整合更多的互连导线并容纳更高的芯片堆栈,需将硅穿孔变得更窄、更高,
- 关键字:异质整合应用材料IC封装CoWoS
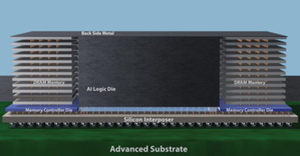
- 应用材料发布新技术与能力,帮助客户加速实现异质芯片设计与整合的技术蓝图。应用材料结合先进封装与大面积基板技术,与产业合作伙伴携手开发新解决方案,大幅改善芯片功率、效能、单位面积成本与上市时间(PPACt)。 应用材料公司加速异质的设计和整合异质整合让不同技术、功能与尺寸规格的芯片得以整合在一个封装中,让半导体与系统业者获得前所未有的设计与制造弹性。应用材料公司是全球最大的先进封装技术供货商,产品线囊括蚀刻(ETCH)、物理气相沉积(PVD)、化学气相沉积(CVD)、电镀(ECD)、化学机械研磨(
- 关键字:应用材料异质整合
异质整合介绍
您好,目前还没有人创建词条异质整合!
欢迎您创建该词条,阐述对异质整合的理解,并与今后在此搜索异质整合的朋友们分享。
创建词条
关于我们-
广告服务-
企业会员服务-
网站地图-
联系我们-
征稿-
友情链接-
手机EEPW
Copyright ©2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《电子产品世界》杂志社 版权所有 北京东晓国际技术信息咨询有限公司

京ICP备12027778号-2 北京市公安局备案:1101082052 京公网安备11010802012473