长电科技Chiplet超大尺寸高密度扇出型倒装封装取得重大突破
5月5日,全球领先的集成电路制造和技术服务提供商长电科技宣布,公司Chiplet技术取得重大突破,超大尺寸高密度扇出型倒装技术实现业界领先的多元异构芯片倒装的102mm x 102mm超高密度封装集成,可广泛应用于高性能计算芯片等高附加值领域。
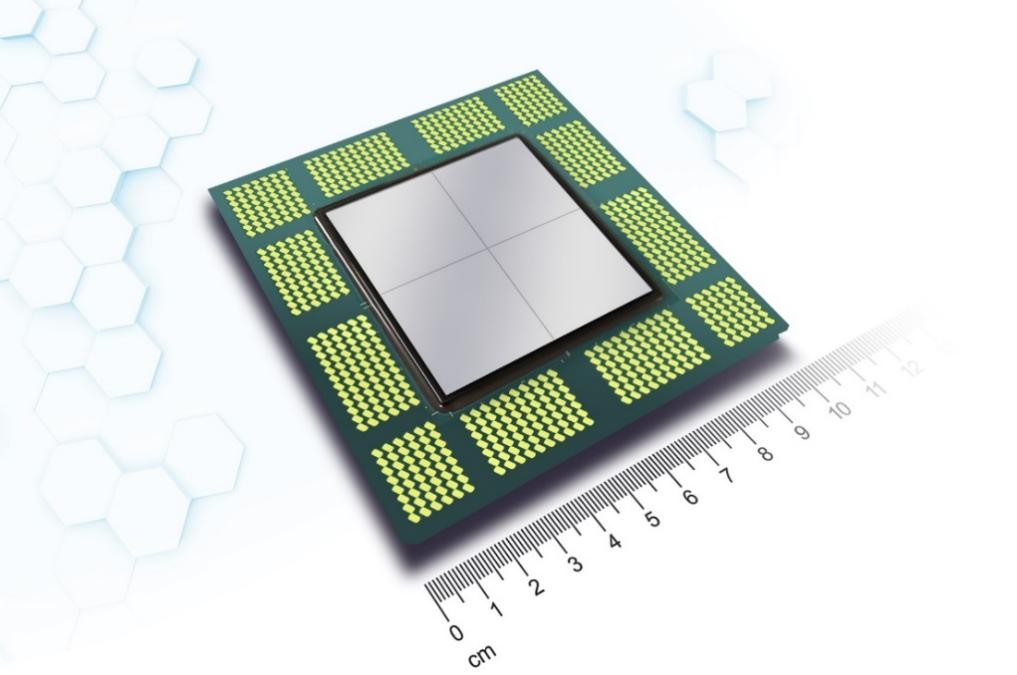
图注:长电科技Chiplet超大尺寸高密度扇出型倒装封装,实现整体封装尺寸超过10000平方毫米的技术突破 (示意图)
当前,人工智能、5G通讯、云计算等高速运算和互联等应用,对芯片性能提出越来越高的要求,同时推动芯片封装技术在大尺寸封装中提供具有高功率完整性、优异的热性能和更高抗电迁移性(EM)的经济高效、可扩展的封装解决方案。
长电科技通过持续的技术研发与客户产品验证,采用XDFOI Chiplet高密度多维异构集成技术,结合超大fcLGA(flip-chip Land Grid Array)封装工艺,将超大尺寸的高密度扇出型封装单元直接倒装在fcLGA基板,实现了整体封装尺寸超过10000平方毫米,扇出单元尺寸超过3600平方毫米的技术突破。同时,长电科技不断优化超大尺寸高密度扇出型集成封装技术,包括工艺的辅助治具、设备升级、扇出结构翘曲控制、双面被动器件贴装工艺等,并开发了多元化的散热片粘结材料和散热界面材料,以满足芯片可靠性的要求,相关工艺达到业内领先水平。
目前,长电科技超大尺寸高密度扇出型集成封装技术可提供从设计到生产的全套交钥匙服务,助力客户显著提升芯片系统集成度,为高性能计算应用提供卓越的微系统集成解决方案。在实现超大尺寸封装技术的同时,长电科技还在前期专利布局的基础上,与客户共同开发了基于高密度扇出封装技术的2.5D fcBGA产品,同时认证通过TSV 异质键合3D SoC的fcBGA。
作为集成电路成品制造领军企业,长电科技已在晶圆级扇出型封装技术领域积累了十余年的量产实践经验,公司XDFOI Chiplet高密度多维异构集成系列工艺已进入稳定量产阶段,同步实现4nm节点多芯片系统集成封装产品出货。未来,长电科技将根据客户基于互联密度和成本的要求,继续投入Chiplet小芯片多样化解决方案的开发,持续为客户提供更加高效、灵活的芯片系统集成解决方案。
-完-
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。