应用材料为20nm制程开发自主式缺陷检测SEM
—— 能拍摄并分析20纳米影响良率的缺陷
应用材料公司推出 Applied SEMVision G5 系统,进一步推升在缺陷检测扫描电子显微镜 (Scanning Electronic Microscope,简称SEM) 技术的领导地位,这是首款可供芯片制造商用于无人生产环境的缺陷检测工具,能拍摄并分析20纳米影响良率的缺陷。
本文引用地址://m.amcfsurvey.com/article/127114.htm据应材表示,SEMVision G5独特的功能可识别并拍摄1纳米画素的缺陷,协助逻辑与内存客户改善制程,比过去更快且更正确地找出造成缺陷的根本原因。
SEMVision G5系统配备最先进的1纳米画素、无与伦比的影像质量及强大的分析引擎,是唯一的缺陷检测扫描电子显微镜,能够在极其困难的线路层上,一边进行识别、分析及发现缺陷,却同时能提高产出。另外,这套系统在区别真假警讯或真假缺陷方面树立了全新的标竿,在测试中,这套系统远比专业的操作员更为准确而快速,能让客户更快更常检查更多晶圆,学习曲线更加速、提升良率也更迅速。
突破性的SEMVision G5为开放架构平台,具有已定义之检测策略链接库,可动态结合接收自晶圆检查系统的数据。此系统可自动建立新的检测程序,这是超越其它竞争对手工具的主要优势,因为其它厂商的工具需要以耗时的手动设定程序,针对每一种芯片类型分别建立检测方式。这项功能对于晶圆代工客户至为关键,因为他们必须在每年制造的数千种新芯片设计中达到良好的产能。




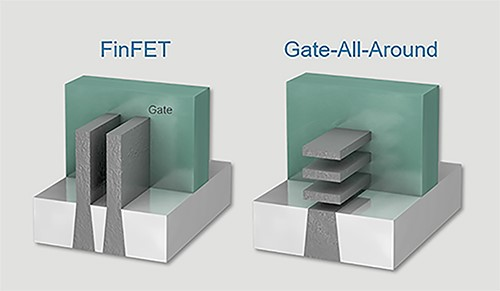



评论