应材新检测设备 支持10纳米
设备大厂应用材料宣布推出新世代的缺陷检测及分类技术,加速达成10纳米及以下的顶尖芯片生产良率。SEMVision G6系统独特的多维影像分析功能为半导体制造提供最高分辨率及影像质量,先进的系统设计与全自主式功能,能提高100%更快速的产出。
本文引用地址://m.amcfsurvey.com/article/147515.htm包括台积电、英特尔等半导体大厂,已经展开10纳米的研发作业,设备大厂应用材料在其SEMVision系列设备上,推出一套最新缺陷检测及分类技术,该设备的缺陷分析系统结合前所未有高分辨率、多维影像分析功能,及革命性创新的Purity自动化缺陷分类(ADC)系统高智能的机器学习算法,同时为半导体产业引进首创缺陷检测扫瞄电子显微镜(DR SEM)技术。
应用材料企业副总裁暨制程诊断与控制事业处总经理依泰.罗森费德(Itai Rosenfeld)表示,在面对新的10纳米设计规则及3D架构技术要求,现有的缺陷检测及分类技术能力面临挑战。新型的SEMVision G6与Purity ADC以影像分析及更快且更准确的强大分类工具,解决半导体业缺陷检测诸多制程控制上最艰钜的问题。
据了解,包括台积电、英特尔在内的多家半导体大厂,已装置应用材料SEMVision G6与Purity ADC系统,并且受惠100%更快速的产出、优异的影像功能和最先进的分类质量,因而提高良率。
SEMVision G6系统设备的分辨率,相较于前一款提高了30%,为业界最高。这项能力与其独特的电子光束倾角,使其优异并且经过实地应用验证的缺陷检测扫描电子显微镜能够辨别、分析及发现3D鳍式场效晶体管(FinFET)及10纳米制程高深宽比结构的缺陷。



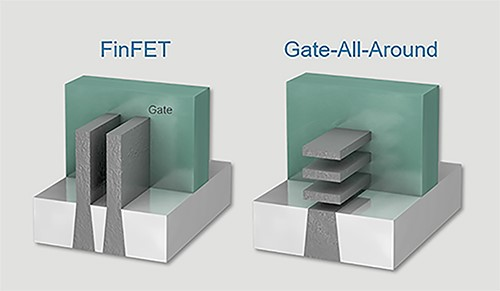




评论