解读FinFET存储器的设计挑战以及测试和修复方法
有些情况下,这些缺陷会是以前在平面工艺中见过的故障模型,但FinFET存储器有几种额外的失效模式。比如,图8给出了一种微妙的失效模式。下拉晶体管中的电阻性鳍片开路导致动态伪读破坏故障(dDRDF)。在此,一个写操作,接着7个读操作,导致存储器单元的位值翻转。然后可以更加详细地分析此故障,因为它原来与频率有关。在1.2MHz频率上,产生这个故障仅用了4次读操作,而在4MHz上,则用了18次读操作。温度和电压也会影响这些值。

图8:缺陷注入调查结果:dDRDF-7
来自Synopsys关于FinFET工艺故障建模的部分普遍结论是:
FinFET存储器比平面存储器对动态故障更敏感
FinFET存储器对制程变异故障更稳定
静态单单元和耦合故障在两种存储器中均很常见
应力角(电压、温度、频率)对于检测FinFET故障非常重要,仅使用标称角会遗漏一些问题。
生成测试序列
故障建模背景完成后,设计人员要明确测试的电压、温度和频率要求。给定应力角的序列与称为测试算法发生器(TAG)的引擎结合。TAG将与针对个别故障类型的小测试序列组合在一起,产生使测试时间和测试成本最小化的最小测试算法。
图9展示了针对FinFET的TAG。图中的过程是全自动的,从故障注入到测试序列识别再到TAG本身。不同的算法片段可以分割以应对不同的应力角和不同的故障检测级别。分割形成了一个针对不同条件的测试序列池,这是由于不同用户和应用具有不同的要求。比如,生产测试期间,设计人员必须识别故障,以便他们能够纠错,但是确定每个故障根源的完整分析可能十分耗时。然而,如果某种错误经常发生,设计人员会执行更加复杂而昂贵的测试,以缩小故障范围,从而能采取相应的纠错措施。
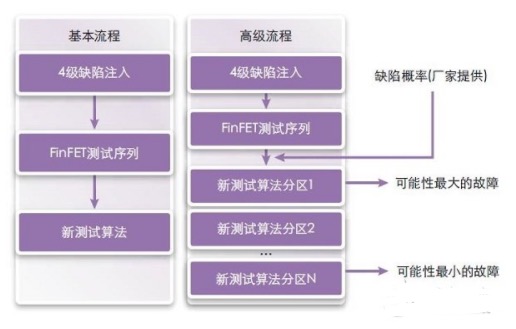
图9:FinFETs测试算法综合
这些过程和测试全部在STAR存储器系统中得以实现,考虑了来自大多数FinFET提供商的故障,这些故障在不同提供商之间具有很大的共性,尽管位单元彼此相差很大。
STAR存储器系统还将可编程能力纳入其中。可以通过JTAG端口和TAP控制器更新算法,修改测试序列本身或为调试和诊断而升级算法,或者就是简单的算法升级,甚至是在现场。
使用STAR存储器系统检测并修复故障
Synopsys对FinFET潜在故障和缺陷的深入而彻底的分析内建在了STAR存储器系统之中,使得该系统可以在很多层次上使用,如图10所示。最高层次是了解哪个存储器例化单元出现失效,这对于生产测试和纠错可能就足够了。下一个层次是故障的逻辑地址和物理地址。






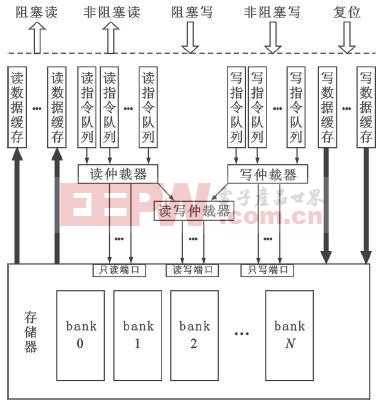

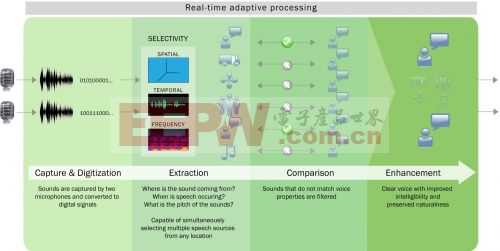




评论