常用手机焊接工具使用方法
电烙铁:用以补焊贴片集成电路虚焊的管脚和清理余锡。
手指钳:焊接时便于将贴片集成电路固定。
医用针头:拆卸时可用于将集成电路掀起。
带灯放大镜:便于观察贴片集成电路的位置。
维修平台:用以固定线路板。维修平台应可靠接地。
防静电手腕:戴在手上,用以防止人身上的静电损坏手机元件器。
小刷子、吹气球:用以扫除贴片集成电路周围的杂质。
助焊剂:可选用GOOT牌助焊剂或松香水(酒精和松香的混合液),将助焊剂加入贴片集成电路管脚周围,便于拆卸和焊接。
无水酒精或天那水:用以清洁线路板。
焊锡:焊接时用以补焊。
二、贴片集成电路拆卸和焊接
1.指导
手机贴片安装的集成电路主要有小外型封装和四方扁平封装两种。小外型封装又称SOP封装,其引脚数目在28之下,引脚分布在两边,手机电路中的码片、字库、电子开关、频率合成器、功放等集成电路常采用这种SOP封装手集成电路。四方扁平封装适用于高频电路和引脚较多的模块,简单QFP封装,四边都有引脚,其引脚数目一般为20以上。如许多中频模块、数据处理器、音频模块、微处理器、电源模块等都采用QFP封装。
这些贴片集成电路的拆卸和安装都必须采用热风枪才能将其拆下或焊接好。和手机中的一些小元件相比,这些贴片集成电路由于相对较大,拆卸和焊接时可将热风枪的风速和温度调得高一些。
2.操作
(1)贴片集成电路的拆卸
在用热风枪拆卸贴片集成电路之前,一定要将手机线路板上的备用电池拆下(特别是备用电池离所拆集成电路较近时),否则,备用电池很容易受热爆炸,对人身构成威胁。
将线路板固定在维修平台上,打开带灯放大镜,仔细观察欲拆卸集成电路的位置和方位,并做好记录,以便焊接时恢复。
用小刷子将贴片集成电路周围的杂质清理干净,往贴片集成电路管脚周围加注少许松香水。
调好热风枪的温度和风速。温度开关一般调至3-5档,风速开关调至2-3档。
用单喷头拆卸时,应注意使喷头和所拆集成电路保持垂直,并沿集成电路周围管脚慢速旋转,均匀加热,喷头不可触及集成电路及周围的外围元件,吹焊的位置要准确,且不可吹跑集成电路周围的外围小件。
待集成电路的管脚焊锡全部熔化后,用医用针头或手指钳将集成电路掀起或镊走,且不可用力,否则,极易损坏集成电路的锡箔。
(2)贴片集成电路的焊接
将焊接点用平头烙铁整理平整,必要时,对焊锡较少焊点应进行补锡,然后,用酒精清洁干净焊点周围的杂质。
将更换的集成电路和电路板上的焊接位置对好,用带灯放大镜进行反复调整,使之完全对正。
先用电烙铁焊好集成电路的四脚,将集成电路固定,然后,再用热风枪吹焊四周。焊好后应注意冷却,不可立即去动集成电路,以免其发生位移。
冷却后,用带灯放大镜检查集成电路的管脚有无虚焊,若有,应用尖头烙铁进行补焊,直至全部正常为止。
用无水酒精将集成电路周围的松香清理干净。
手机BGA芯片的拆卸和焊接
1、BGA芯片拆卸和焊接工具
拆卸手机BGA芯片前要准备好以下工具:
热风枪:用于拆卸和焊接BGA芯片。最好使用有数控恒温功能的热风枪,容易掌握温度,去掉风嘴直接吹焊。
电烙铁:用以清理BGA芯片及线路板上的余锡。
手指钳:焊接时便于将BGA芯片固定。
医用针头:拆卸时用于将BGA芯片掀起。
带灯放大镜:便于观察BGA芯片的位置。
维修平台:用以固定线路板。维修平台应可靠接地。
防静电手腕:戴在手上,用以防止人身上的静电损坏手机元件器。
小刷子、吹气球:用以扫除BGA芯片周围的杂质。
助焊剂:建议选用日本产的GOOT牌助焊剂,呈白色,其优点一是助焊效果极好,二是对IC和PCB没有腐蚀性,三是其沸点仅稍高于焊锡的熔点,在焊接时焊锡熔化不久便开始沸腾吸热汽化,可使IC和PCB的温度保持在这个温度。另外,也可选用松香水之类的助焊剂,效果也很好。
无水酒精或天那水:用以清洁线路板。用天那水最好,天那水对松香助焊膏等有极好的溶解性。
焊锡:焊接时用以补焊。
植锡板:用于BGA芯片置锡。市售的植锡板大体分为两类:一种是把所有型号的BGAIC都集在一块大的连体植锡板上;另一种是每种IC一块板,这两种植锡板的使用方式不一样。连体植锡板的使用方法是将锡浆印到IC上后,就把植锡板扯开,然后再用热风枪吹成球。这种方法的优点是操作简单成球快,缺点一是锡浆不能太稀,二是对于有些不容易上锡的IC,例如软封的Flash或去胶后的CPU,吹球的时候锡球会乱滚,极难上锡,一次植锡后不能对锡球的大小及空缺点进行二次处理。三是植锡时不能连植锡板一起用热风枪吹,否则植锡板会变形隆起,造成无法植锡。小植锡板的使用方法是将IC固定到植锡板下面后,刮好锡浆后连板一起吹,成球冷却后再将IC取下。它的优点是热风吹时植锡板基本不变形,一次植锡后若有缺脚或锡球过大过小现象可进行二次处理,特别适合初学者使用。下面介绍的方法都是使用这种植锡板。另外,在选用植锡板时,应选用喇叭型、激光打孔的植锡板,要注意的是,现在市售的很多植锡板都不是激光加工的,而是靠化学腐蚀法,这种植踢板除孔壁粗糙不规则外,其网孔没有喇叭型或出现双面喇叭型,这类钢片植锡板在植锡时就十分困难,成功率很低。
锡浆:用于置锡,建议使用瓶装的进口锡浆,多为0.5~1公斤一瓶。颗粒细腻均匀,稍干的为上乘,不建议购买那种注射器装的锡浆。在应急使用中,锡浆也可自制,可用熔点较低的普通焊锡丝用热风枪熔化成块,用细砂轮磨成粉末状后,然后用适量助焊剂搅拌均匀后使用。
刮浆工具:用于刮除锡浆。可选用GOOT六件一套的助焊工具中的扁口刀。一般的植锡套装工具都配有钢片刮刀或胶条。
二、BGA芯片的拆卸和焊接
1.指导
随着全球移动通信技术日新月异的发展,众多的手机厂商竞相推出了外形小巧功能强大的新型手机。在这些新型手机中,普遍采用了先进的BGAIC(Balld arrays球栅阵列封装),这种已经普及的技术可大大缩小手机的体积,增强功能,减小功耗,降低生产成本。但万事万物一样有利则有弊,BGA封装IC很容易因摔引起虚焊,给维修工作带来了很大的困难。
BGA封装的芯片均采用精密的光学贴片仪器进行安装,误差只有0.01mm,而在实际的维修工作中,大部分维修者并没有贴片机之类的设备,光凭热风机和感觉进行焊接安装,成功的机会微乎其微。
要正确地更换一块BGA芯片,除具备熟练使用热风枪、BGA置锡工具之外,还必须掌握一定的技巧和正确的拆焊方法。这些方法和技巧将在下面实习操作时进行介绍
2.操作
(1)BGA IC的定位
在拆卸BGAIC之前,一定要搞清BGA-IC的具体位置,以方便焊接安装。在一些手机的线路板上,事先印有BGA-IC的定位框,这种IC的焊接定位一般不成问题。下面,主要介绍线路板上没有定位框的情况下IC的定位的方法。
画线定位法。拆下IC之前用笔或针头在BGA-IC的周周画好线,记住方向,作好记号,为重焊作准备。这种方法的优点是准确方便,缺点是用笔画的线容易被清洗掉,用针头画线如果力度掌握不好,容易伤及线路板。
贴纸定位法。拆下BGA-IC之前,先沿着IC的四边用标签纸在线路板上贴好,纸的边缘与BGA-IC的边缘对齐,用镊子压实粘牢。这样




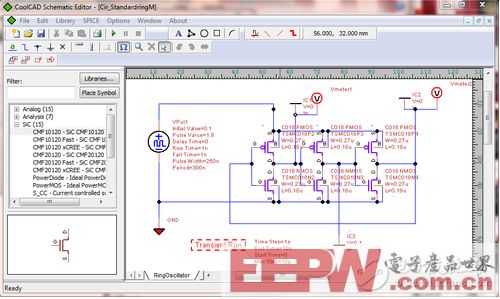









评论