常用手机焊接工具使用方法
目测法。拆卸BGA-IC前,先将IC竖起来,这时就可以同时看见IC和线路板上的引脚,先横向比较一下焊接位置,再纵向比较一下焊接位置。记住IC的边缘在纵横方向上与线路板上的哪条线路重合或与哪个元件平行,然后根据目测的结果按照参照物来定位IC。
(2)BGA-IC拆卸
认清BGA芯片放置之后应在芯片上面放适量助焊剂,既可防止干吹,又可帮助芯片底下的焊点均匀熔化,不会伤害旁边的元器件。
去掉热风枪前面的套头用大头,将热量开关一般调至3-4档,风速开关调至2-3档,在芯片上方约2.5cm处作螺旋状吹,直到芯片底下的锡珠完全熔解,用镊子轻轻托起整个芯片。
需要说明两点:一是在拆卸BGAIC时,要注意观察是否会影响到周边的元件,如摩托罗拉L2000手机,在拆卸字库时,必须将SIM卡座连接器拆下,否则,很容易将其吹坏。二是摩托罗拉T2688、三星A188、爱立信T28的功放及很多软封装的字库,这些BGA-IC耐高温能力差,吹焊时温度不易过高(应控制在200度以下),否则,很容易将它们吹坏。
BGA芯片取下后,芯片的焊盘上和手机板上都有余锡,此时,在线路板上加上足量的助焊膏,用电烙铁将板上多余的焊锡去除,并且可适当上锡使线路板的每个焊脚都光滑圆润(不能用吸锡线将焊点吸平)。然后再用天那水将芯片和的机板上的助焊剂洗干净。吸锡的时候应特别小心,否则会刮掉焊盘上面的绿漆和焊盘脱落。
(3)植锡操作
做好准备工作。对于拆下的IC,建议不要将IC表面上的焊锡清除,只要不是过大,且不影响与植锡钢板配合即可,如果某处焊锡较大,可在BGAIC表面加上适量的助焊膏,用电烙铁将IC上的过大焊锡去除(注意最好不要使用吸锡线去吸,因为对于那些软封装的IC例如摩托罗拉的字库,如果用吸锡线去吸的话,会造成IC的焊脚缩进褐色的软皮里面,造成上锡困难),然后用天那水洗净。
BGA-IC的固定。将IC对准植锡板的孔后(注意,如果使用的是那种一边孔大一边孔小的植锡板,大孔一边应该与IC紧贴),用标签贴纸将IC与植锡板贴牢,IC对准后,把植锡板用手或镊子按牢不动,然后另一只手刮浆上锡。
上锡浆。如果锡浆太稀,吹焊时就容易沸腾导致成球困难,因此锡浆越干越好,只要不是干得发硬成块即可。如果太稀,可用餐巾纸压一压吸干一点。平时可挑一些锡浆放在锡浆瓶的内盖上,让它自然晾干一点。用平口刀挑适量锡浆到植锡板上,用力往下刮,边刮边压,使锡浆均匀地填充于植锡板的小孔中。
注意特别“关照”一下IC四角的小孔。上锡浆时的关键在于要压紧植锡板,如果不压紧使植锡板与IC之间存在空隙的话,空隙中的锡浆将会影响锡球的生成。
吹焊成球。将热风枪的风嘴去掉,将风量调至最小,将温度调至330--340度,也就是3-4档位。晃风嘴对着植锡板缓缓均匀加热,使锡浆慢慢熔化。当看见植锡板的个别小孔中已有锡球生成时,说明温度已经到位,这时应当抬高热风枪的风嘴,避免温度继续上升。过高的温度会使锡浆剧烈沸腾,造成植锡失败;严重的还会使IC过热损坏。
如果吹焊成球后,发现有些锡球大小不均匀,甚至有个别脚没植上锡,可先用裁纸刀沿着植锡板的表面将过大锡球的露出部分削平,再用刮刀将锡球过小和缺脚的小孔中上满锡浆,然后用热风枪再吹一次即可。如果锡球大小还不均匀的话,可重复上述操作直至理想状态。重植时,必须将置锡板清洗干净、擦干。
(4)BGA-IC的安装
先将BGA-IC有焊脚的那一面涂上适量助焊膏,用热风枪轻轻吹一吹,使助焊膏均匀分布于IC的表面,为焊接作准备。再将植好锡球的BGA-IC按拆卸前的定位位置放到线路板上,同时,用手或镊子将IC前后左右移动并轻轻加压,这时可以感觉到两边焊脚的接触情况。因为两边的焊脚都是圆的,所以来回移动时如果对准了,IC有一种“爬到了坡顶”的感觉,对准后,因为事先在IC的脚上涂了一点助焊膏,有一定粘性,IC木会移动。如果IC对偏了,要重新定位。
BGA-IC定好位后,就可以焊接了。和植锡球时一样,把热风枪的风嘴去掉,调节至合适的风量和温度,让风嘴的中央对准IC的中央位置,缓慢加热。当看到IC往下一沉且四周有助焊膏溢出时,说明锡球已和线路板上的焊点熔合在一起。这时可以轻轻晃动热风枪使加热均匀充分,由于表面张力的作用,BGA-IC与线路板的焊点之间会自动对准定位,注意在加热过程中切勿用力按住BGA-IC,否则会使焊锡外溢,极易造成脱脚和短路。焊接完成后用天那水将板洗干净即可。
在吹焊BGA-IC时,高温常常会影响旁边一些封了胶的IC,往往造成不开机等故障。用手机上拆下来的屏蔽盖盖住都不管用,因为屏蔽盖挡得住你的眼睛,却挡不住热风。此时,可在旁边的IC上面滴上几滴水,水受热蒸发是会吸去大量的热,只要水不干,旁边IC的温度就是保持在100度左右的安全温度,这样就不会出事了。当然,也可以用耐高温的胶带将周围元件或集成电路粘贴起来。
三、常见问题的处理方法
1.没有相应植锡板的BGA-IC的植锡方法
对于有些机型的BGA-IC,手头上如果没有这种类型的植锡板,可先试试手头上现有的植锡板中有没有和那块BGA-IC的焊脚间距一样,能够套得上的,即使植锡板上有一些脚空掉也没关系,只要能将BGAIC的每个脚都植上锡球即可,例如GD90的CPU和Flash可用998CPU和电源IC的植锡板来套用。
2.胶质固定的BGAIC的拆取方法
很多手机的BGA-IC采用了胶质固定方法,这种胶很难对付,要取下BGAIC相当困难,下面介绍几种常用的方法,供拆卸时参考。
(1)对摩托罗拉手机有底胶的BGA-IC,用目前市场上出售的许多品牌的胶水基本上都可以达到要求。经实验发现,用香蕉水(油漆稀释剂)浸泡效果较好,只需浸泡3至4小时就可以把BGA-IC取下。
(2)有些手机的的BGA-IC底胶是502胶(如诺基亚8810手机),在用热风枪吹焊时,就可以闻到502的气味,用丙酮浸泡较好。
(3)有些诺基亚手机的底胶进行了特殊注塑,目前无比较好的溶解方法,拆卸时要注意拆卸技巧,由于底胶和焊锡受热膨胀的程度是不一样的,往往是焊锡还没有溶化胶就先膨胀了。所以,吹焊时,热风枪调温不要太高,在吹焊的同时,用镊子稍用力下按,会发现BGA-IC四周有焊锡小珠溢出,说明压得有效,吹得差不多时就可以平移一下BGA-IC,若能平移动,说明,底部都已溶化,这时将BGA-IC揭起来就比较安全了。
需要说明的是:对于摩托罗拉V998手机,浸泡前一定要把字库取下,否则,字库会损坏。因为V998的字库是软封装的BGA,是不能用香蕉水、天那水或溶胶水泡的。因这些溶剂对软封的BGA字库中的胶有较强腐蚀性,会使胶膨胀导致字库报废。
3.线路板脱漆的处理方法
例如,在更换V998的CPU时,拆下CPU后很可能会发现线路板上的绿色阻焊层有脱漆现象,重装CPU后手机发生大电流故障,用手触摸CPU有发烫迹象。一定是CPU下面阻焊层被破坏的原因,重焊CPU发生了短路现象。
这种现象在拆焊V998的CPU时,是很常见的,主要原因是用溶济浸泡的时间不够,没有泡透。另外在拆下CPU时,要一边用热风吹,一边用镊子在CPU表面的各个部位充分轻按,这样对预防线路板脱漆和线路板焊点断脚有很好的预防作用。
如果发生了“脱漆”现象,可以到生产线路板的厂家找专用的阻焊剂(俗称“绿油”)涂抹在“脱漆”的地方,待其稍干后,用烙铁将线路板的焊点点开便可焊上新的CPU。另外,我们在市面上买的原装封装的CPU上的锡球都较大,容易造成短路,而我们用植锡板做的锡球都较小。可将原采的锡球去除,重新植锡后再装到线路板上,这样就不容易发生短路现象。
4.焊点断脚的处理方法
许多手机,由于摔跌或拆卸时不注意,很容易造成BGA-IC下的线路板的焊点断脚。此时,应首先将线路板放到显微镜下观察,确定哪些是空脚,哪些确实断了。如果只是看到一个底部光滑的“小窝”,旁边并没有线
路延伸,这就是空脚,可不做理会;如果断脚的旁边有线路延伸或底部有扯开的,毛刺,则说明该点不是空脚,



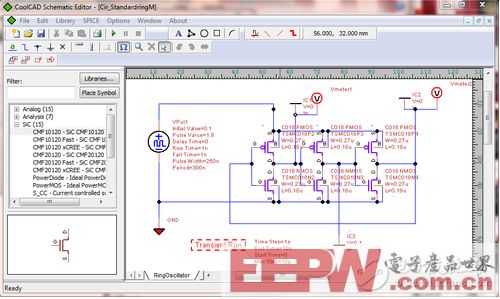










评论