HID灯镇流器中UniFET II MOSFET的性能和效率
UniFET IIMOSFET
本文引用地址://m.amcfsurvey.com/article/142700.htm功率MOSFET的结构及其故障机理
功率MOSFET因其栅极驱动功能简单、开关速度快及其他特性,成为最常用的功率器件。 通常情况下,功率MOSFET采用纵向结构,称为DMOS(双扩散MOS)。 DMOS功率MOSFET的纵向结构及其等效MOSFET电路如图1所示。 该纵向结构因漏极和源极位于硅晶圆的两对面而适用于高电压器件,通过扩大外延层(漏极漂移区)可提高高电压阻隔能力,同时还可增大沟道导通电阻。
在功率MOSFET中,要注意三种类型的异常故障模式,如下所述[9-10]。
寄生BJT误导通
从根本上说,寄生双极结型晶体管(BJT)的基极和发射极对源极金属来说很普遍。 因此,不应激活寄生BJT。 然而,事实上,基极与源极金属之间存在极小的体电阻(Rb),如图1所示。 如果漏极体电容(Cdb)上出现高强度的dv/dt,则巨大的位移电流便会流经Rb,而且Rb上的电压将会变得足够大(大于-0.65 V),直至触发寄生BJT。 由于负温度系数(NTC),一旦寄生BJT导通,便会形成过热点,而且还会集中更多电流,这最终会导致器件发生故障。
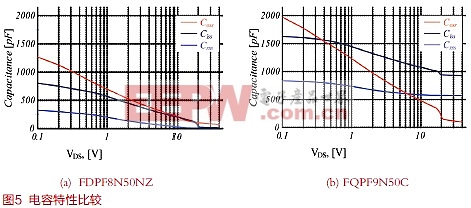
nMOS沟道无意导通
dv/dt过高也会导致nMOS沟道意外导通。 如果MOSFET的漏极与源极之间出现的dv/dt过高,则巨大的位移电流(Cgd× dv/dt)将会流经由栅极至漏极电容(Cgd)、外部栅极电阻(Rg)和并行栅极至源极电容(Cgs)形成的路径,如图1(b)所示。 如果Cgs相对小于Cgd,则更多的电流将流经Rg,因此Rg上的压降将超过MOSFET的阈值电压(VGS(th))。 其结果是,MOSFET将会导通,而自热现象最终会损坏器件。
体二极管反向恢复故障
每一个功率MOSFET在p体与n外延层的结点处都有一个固有体二极管,它可以有效地用作续流二极管。 但是,与FRD相比,体二极管的反向恢复特性非常差。 因此,如果在高电流流经体二极管期间出现反向恢复模式,则必然会流通过高的直通电流,并最终对器件造成损坏。
UniFET II MOSFET技术
最近,飞兆开发了UniFET II MOSFET,该技术可通过优化有效单元结构提高外延层条件(厚度和电阻率)下的击穿电压。 因此,在额定击穿电压相同的条件下,新MOSFET技术的品质因数要优于传统MOSFET技术的品质因数,其Qg*RDS(on)约为传统平面MOSFET的一半。 寿命控制流程也得到了应用,该流程可提高体二极管的dv/dt强度和反向恢复性能。
寿命控制是一个在硅能带中的导电带和价电带之间产生深度陷波电平的流程。 能源陷波电平越深,则电力载波(空穴和电子)的重新组合和重新生成也就越快。 通过寿命控制,体二极管的某些特性会显著提升,比如Trr、Qrr和Irr;而有些特性则会下降,比如体二极管(VF)的正向压降和RDS(on)[8,14-15]。
得到显著提高的寿命控制流程会使UniFET II MOSFET拥有卓越的dv/dt特性和体二极管性能。 图2显示的是根据寿命控制集中程度的RDS(on)与体二极管反向恢复时间(Trr)之间的权衡关系。 从图2中可明显看出,寿命控制越深入,Trr特性(即体二极管反向恢复时间)也就越短; 然而,过度的寿命控制会在逐步提升Trr的同时导致RDS(on)的不必要增大。 根据寿命控制的集中程度,UniFET II MOSFET可分为普通FET、FRFET和UltraFRFETTMMOSFET,其Trr分别为传统MOSFET的70%、25%和15%左右。
图3对UniFET II MOSFET系列、传统MOSFET和FRD的反向恢复性能结果进行了比较。 该图清楚地表明,UniFET II MOSFET系列的反向恢复特性要优于传统MOSFET,甚至比FRD还要好 – 就UniFET II UltraFRFETMOSFET来说,在Ipk=2A的情况下,Trr为35.2 nsec,且irr为2.3 A;但在同等条件下,传统MOSFET的Trr为228.2 nsec,且irr为10.5 A,而FRD的Trr为36.2 nsec,且irr为3.0 A。 更为详细的测试结果如表1所示。
UniFET II MOSFET的寿命控制流程同样可提高强健体二极管dv/dt的强度,从而实现更高的系统可靠性。 UniFET II MOSFET与传统MOSFET之间的dv/dt强度比较波形如图4所示。 传统MOSFET在6.87 V/nsec的dv/dt下损坏,而普通UniFET II MOSFET在11.65 V/nsec的dv/dt下仍然可以继续使用,这种水平在实践中极为少见。
通过优化有效单元结构,UniFET II MOSFET的寄生电容也会显著降低,从而有利于高频开关操作。 图5分别显示的是传统平面MOSFET FQPF9N50C和UniFET II MOSFET FDPF8N50NZ的电容特性。 在RDS(on)相同的条件下,UniFET II MOSFET的电容仅仅约为传统平面MOSFET的一半。











评论